Used JEOL JSM 6340F #145143 for sale
URL successfully copied!
Tap to zoom










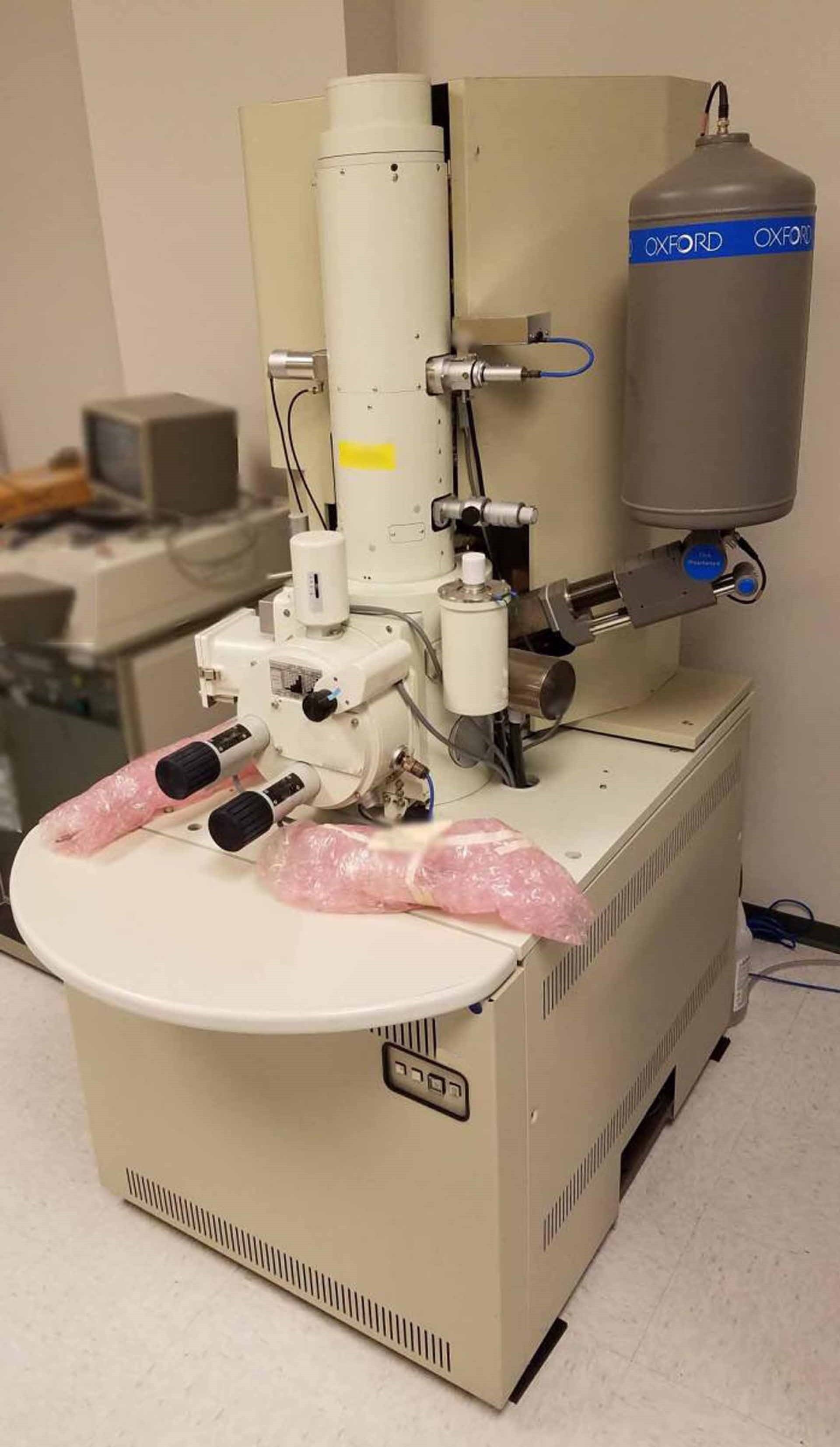



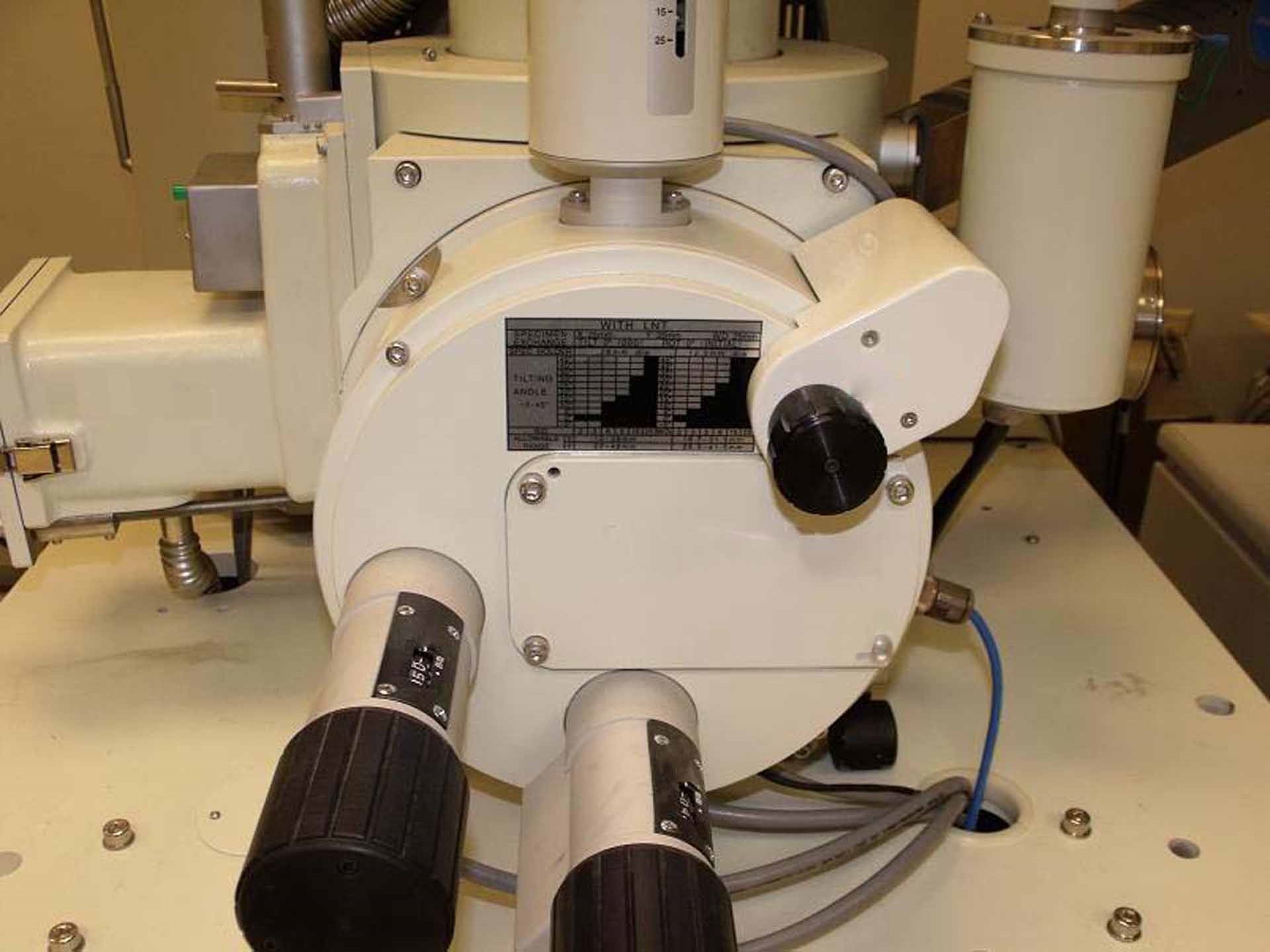

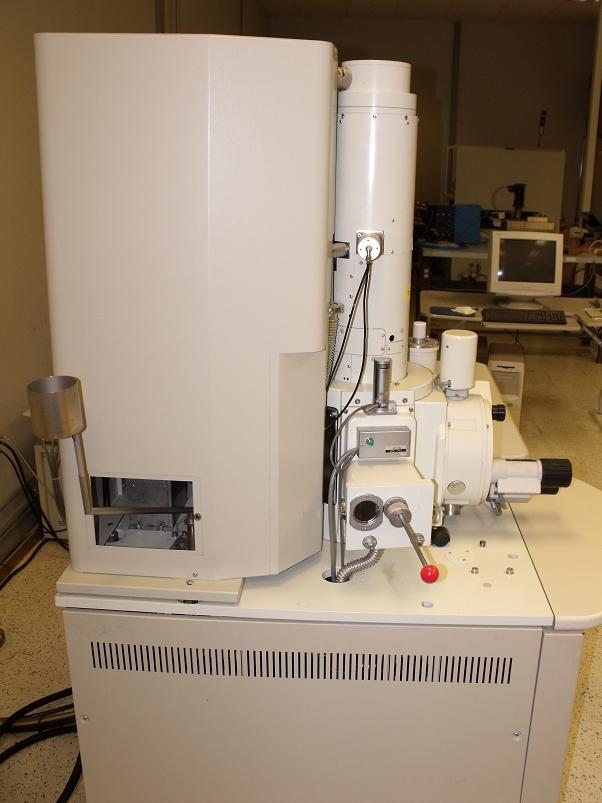















ID: 145143
Wafer Size: 4"
Scanning electron microscope, 4", parts system
Specifications:
In-lens secondary electron detector
Resolution: 2.5nm at 1kV
1.2nm at 20kV
Sample size: 4"
X-Direction: 50 mm
Y-Direction: 70 mm
Chamber:
Airlock, 4"
LN2 cold trap
EDX Capabilities
Chamber camera & monitor
X-Stream imaging system
Operating system: Windows XP
Image capture & networking capability.
JEOL JSM 6340F is a high-performance scanning electron microscope (SEM) offering excellent imaging capabilities. This equipment is designed for a variety of applications in the areas of materials science, semiconductor, nanotechnology and biology research. JEOL JSM-6340F features a fully automated, compact column design and is equipped with a range of detectors, including an EDX (energy dispersive X-ray spectrometer) system, a backscatter electron (BSE) detector and a secondary electron (SE) detector. This SEM is also equipped with a top-of-the-line low-vacuum (LV) secondary electron imaging unit. The fully automated scan control offers fast and reliable data acquisition, allowing for high-resolution imaging of a variety of sample types over a wide range of magnifications. The high-performance SE detector increases the contrast and sharpness of images captured at high magnifications. A unique feature of JSM 6340 F is its excellent low-vacuum secondary electron imaging machine which The technology offers a wide range of magnification from 5x to 300,000x, providing researchers with a powerful tool for analyzing samples at multiple scales. The tool offers a variety of specimen stages, including a large-diameter, low-background LV sample initialization feature and an automated translation stage. JSM 6340F offers a wide range of features to make data acquisition and analysis simpler and faster. Automatic scan speed control ensures accurate sample preparation and imaging. The backscatter electron (BSE) detector helps researchers determine the composition and characteristics of the sample. The energy dispersive X-ray spectrometer (EDX) enables users to quickly analyze unknown sample elements and perform elemental analysis. Furthermore, the asset comes equipped with a multiscale imaging software, allowing users to effortlessly manipulate images captured by JEOL JSM 6340 F. This advanced software offers an array of features such as auto-scaling, color coding and zooming, enabling researchers to more effectively analyze their data. In summary, JSM-6340 F scanning electron microscope is the ideal tool for a broad range of materials science, semiconductor, nanotechnology and biological research applications. The highly automated instrument provides excellent imaging capabilities at a range of magnifications from 5x to 300000x. In addition, the model is equipped with a wide range of detectors, including a backscatter electron (BSE) detector, an energy dispersive X-ray spectrometer (EDX) equipment and a top-of-the-line low-vacuum (LV) secondary electron imaging system. To facilitate further data analysis, the instrument also features an advanced multiscale imaging software.
There are no reviews yet















