Used ESEC 2008 HS #293645932 for sale
URL successfully copied!
Tap to zoom
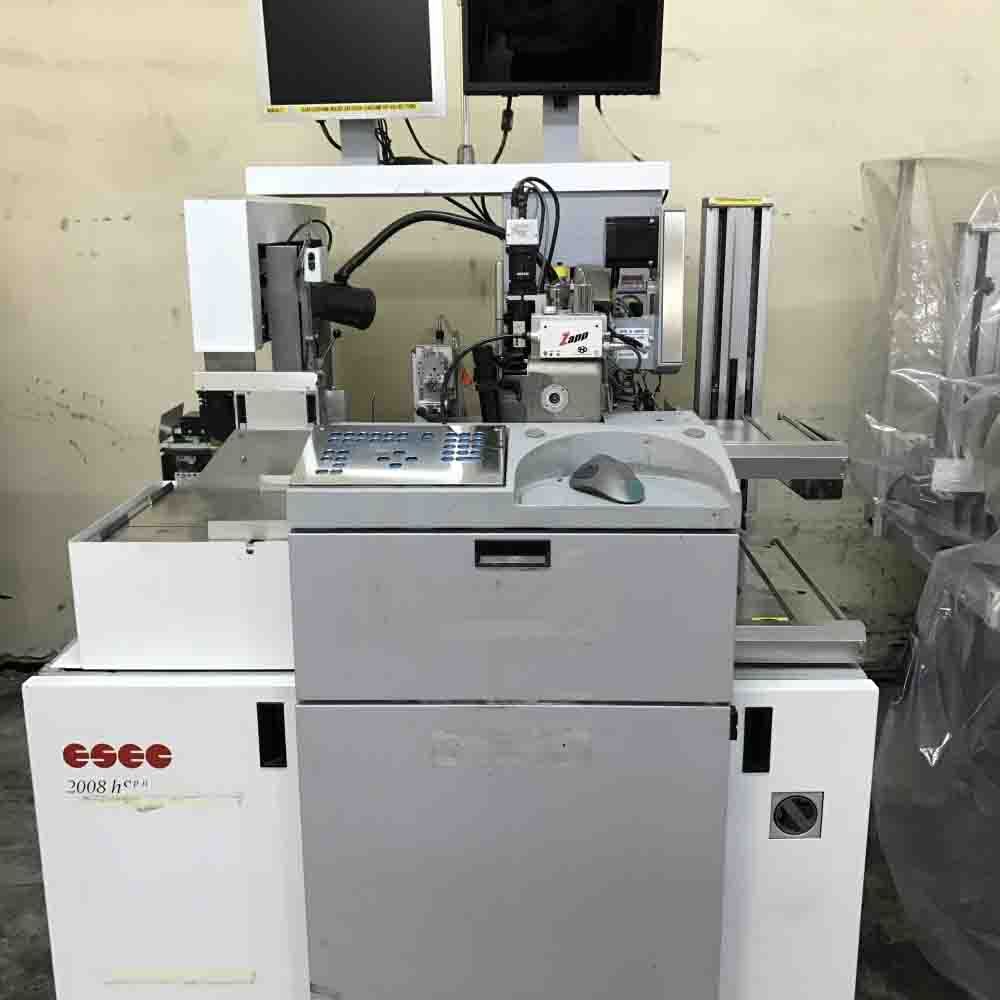

ESEC 2008 HS is an automated mechanical die-attaching equipment for interconnecting integrated circuits and substrates. It uses advanced technology to attach a gold wire to each bond pad, allowing it to establish a reliable electrical connection between the two surfaces. The system features an enhanced pin-feeder and dual-sided wire crimping capabilities, as well as an integrated vision unit to ensure the highest quality connections. 2008 HS utilizes an innovative and reliable adhesive-dispensing machine, which applies a controlled amount of adhesive to the wire and bond pad simultaneously. This ensures a secure bond, allowing the electrical connection between the integrated circuit and the substrate to take place without any fear of signal interference. The expansion and contraction of the adhesive also helps reduce the amount of stress on the connection. The unit also comes equipped with a laser-based pre-solder inspection tool that is designed to reject any wires that are of insufficient quality. This helps reduce the amount of defective connections, which can potentially lead to signal leakage or tarnished performance. ESEC 2008 HS features a fully automated operation that is both quick and reliable. An operator is only required to load the integrated circuit and the substrate, leaving the rest of the process to the automatic fetch-and-place mechanism. This helps minimize the amount of time and manual effort needed to attach the integrated circuit to the substrate. Also, the unit can operate in both batch and single-mode operations and supports a wide range of feeders for both wire ball and wire-bond. 2008 HS is designed for use in high-volume and high-reliability applications. It is available in 2 or 4 output platforms, providing the scalability needed for different production volumes. Lastly, the unit offers a user-friendly interface with a built-in, graphical diagnostics display that can be used to easily identify and troubleshoot any potential issue throughout the bond process.
There are no reviews yet