Used ESEC 3088iP #9091720 for sale
URL successfully copied!
Tap to zoom
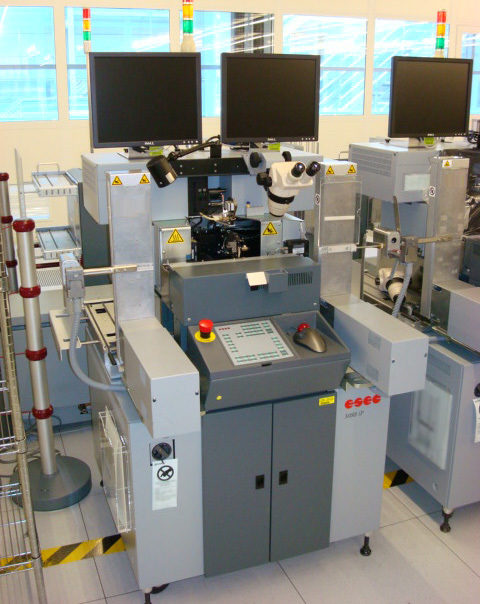

ID: 9091720
Vintage: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Max. bonding area: 52 x 64mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227mm / 8.93"
Width (adjustable): 120mm / 4.72" to 260mm / 10.23"
2002 vintage.
ESEC 3088iP is an industrial semiconductor packaging machine designed to form tight electrical connections between the individual pins of a semiconductor chip and its leads. The machine utilizes an advanced Wedge and Bar bonder technique to enable for high throughput manufacturing of precision semiconductor packages. ESEC 3088I P package is composed of several major components including a touch-screen digital interface, an ultrasonic bonder head, an alignment system, a parameter control unit, and a bond data control unit. The digital interface allows for easy and intuitive machine control along with the selection and display of process parameters. The ultrasonic bonder head is composed of a dual axis system that is capable of handling a wide range of package sizes and lead lengths. The alignment system is composed of a microscope, a CCD line scan camera, and a translation micrometer head. This combination of components is capable of measuring the alignment between the printed circuit board and the chip's leads to ensure accurate bond placement. The parameter control unit is used to control the various properties of the bond process such as frequency, power, flux, wedge force, electrode blade pressure, and bond force. The bond data control unit is used to store and monitor the bond data for quality assurance and traceability purposes. 3088 IP unit offers a fast and convenient bonding solution for automated manufacturing processes. The machine has a high throughput rate and can handle a variety of different semiconductor packages including multi-chip modules (MCM), quad flat no-lead packages (QFN), small outline integrated circuits (SOIC), and chip scale packages (CSP). It also includes advanced features such as automatic power and temperature management, advanced flux control, pulse oscillation, and multi-point force control. The overall design of the machine greatly reduces the risk of damaging the package or leads during the bonding process. Additionally, the high-quality results that the machine produces enables for error-free operation and creates a level of confidence with the user that the bond operations are performed with the highest accuracy and reliability.
There are no reviews yet