Used ESEC 3088iP #9091724 for sale
URL successfully copied!
Tap to zoom
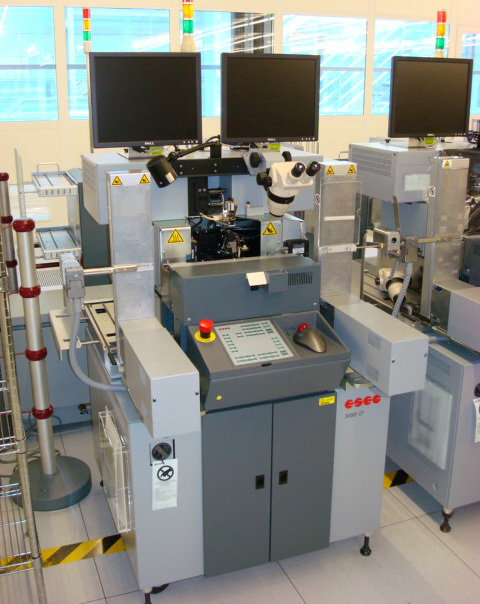

ID: 9091724
Vintage: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Max. bonding area: 52 x 64mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227mm / 8.93"
Width (adjustable): 120mm / 4.72" to 260mm / 10.23"
2002 vintage.
ESEC 3088iP is an intelligent, high performance die bonder from ESEC Corporation. It is designed to help manufacturers achieve the highest possible yields with precision, speed and accuracy. It is specifically engineered to make die bonding tasks easier and faster than ever before. ESEC 3088I P features a state-of-the-art vision equipment that enables operators to accurately identify and align replacement dies with maximum precision. It also features an integrated microcontroller that monitors and adjusts processes in real time to ensure the highest levels of accuracy and performance. 3088 IP can handle a variety of package types and sizes including SIP, ALUMINUM, CSP, DIP, DIE plates and more. 3088I P is powered by a sophisticated microprocessor that helps manage and adjust the die bonding process for optimum performance. It is constructed from high-grade stainless steel and materials that enable it to withstand tough production environments. It also features built-in roller and press systems for precise and repeatable motion to ensure that dies are accurately placed and seated. 3088iP features a die attach system that can accommodate many different bonder insert styles and configurations. It supports both soldering and adhesive bond processes. It is capable of creating a variety of thinner, flatter and more repeatable die bonds than ever before. Additionally, it features a built-in vision unit with a choice of standard and hyper-zoom vision systems that allow operators to identify and locate dies with outstanding accuracy. Furthermore, ESEC 3088 IP has an integrated wafer cleaner that removes material particles prior to bonding and a top mounted die adjustment machine that enables operators to precisely adjust die placement for optimum results. It also includes an automated status monitor and warning tool that provides timely notifications when it is necessary to take corrective action. In conclusion, ESEC 3088iP is an intelligent, high-performance bonder featuring state-of-the-art vision systems and microprocessor-controlled processes. It is capable of producing a variety of different die bonds as well as providing accurate and repeatable motion. It is an ideal choice for manufacturers who are looking for maximum performance and reliability from their die bonder.
There are no reviews yet