Used ESEC 3088iP #9091727 for sale
URL successfully copied!
Tap to zoom
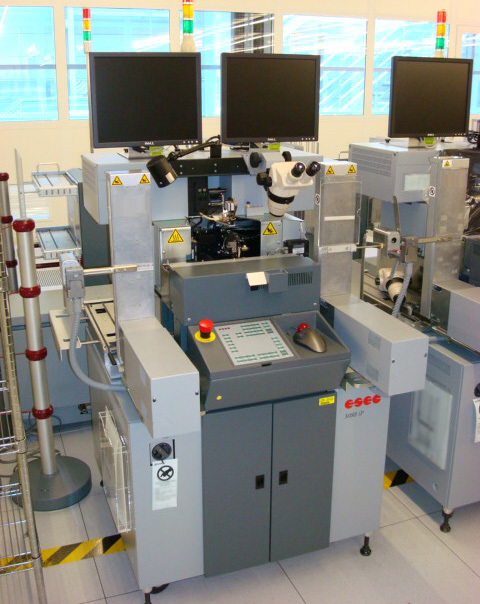

ID: 9091727
Vintage: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Max. bonding area: 52 x 64mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227mm / 8.93"
Width (adjustable): 120mm / 4.72" to 260mm / 10.23"
2002 vintage.
ESEC 3088iP is a fully automated bonder that provides advanced die and wirebonding capabilities for microelectronic and optoelectronic assemblies. Designed for high-volume production, this fully-integrated platform utilizes advanced wafer-level-packaging and die-attach techniques for sub-micron accuracy and extremely precise wire-to-die, wire-to-wire, and die-to-die bond joints. ESEC 3088I P is engineered with a high emphasis on bonds, recognizing that quality and reliability begins at the bond level. 3088 IP incorporates both ultrasonic wedge bonding (UWB) and thermocompression (TCB) technologies, enabling the user to choose the best bond option for each specific application. The wirebonding head is capable of achieving down-to-wire diameters as fine as 25µm, while the die attach system enables repeatable placement accuracy of ±5µm or less. 3088I P is also equipped with a modular camera system that provides both vision alignment and post-bond quality assurance. Adjustable lighting directions, both backlight and low-light options, and adjustable zoom capabilities enable the user to inspect for solder ball placement errors, missing features and other potential board defects before and/or after bond formation. The integrated vision system can also measure bond lengths, loop heights, and loop area diameters to ensure quality post bond connections. The VP 8000 operating software of 3088iP supports both 12" and 6" 450mm substrates, and is configurable for both stacked and single cards. It provides programmable dispense and conveyor speeds for optimal production throughput, as well as customizable diameter, wire pitch and pitch counts. Additional programming features enable users to easily adjust wire alignment, loop position, wire insulation, and crimp height. ESEC 3088 IP facilitates a variety ofwafer-level-packaging and die attach applications, including flip-chip die attach, MEMS packaging and flip-chip-on-tape projects. Its advanced technology and user-friendly features enable it to meet the most demanding production requirements, reaching speeds of up to twenty thousand bonds per hour and accuracy tolerance as fine as ±2µm. ESEC 3088iP is a versatile, reliable and efficient bonder designed to enable complete microassembly.
There are no reviews yet