Used ESEC 3088iP #9091745 for sale
URL successfully copied!
Tap to zoom
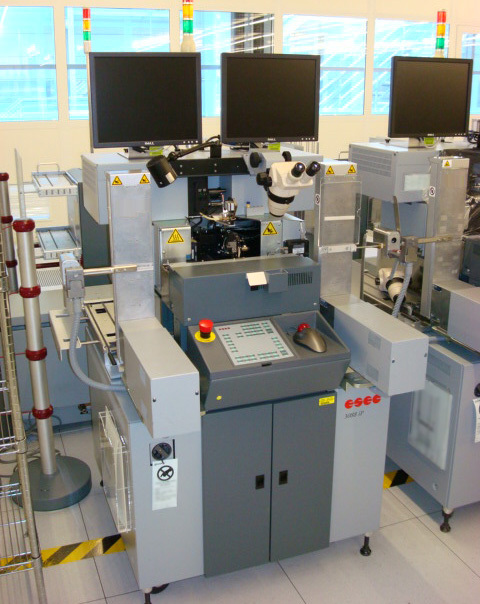

ID: 9091745
Vintage: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Maximum bonding area: 52 x 64 mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / Post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / Post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227 mm / 8.93"
Width (Adjustable): 120 mm / 4.72" to 260 mm / 10.23"
2003 vintage.
ESEC 3088iP is a semi-automatic wire and ribbon bonder for use in semiconductor industries. This bonder is well-suited for both back-grinding and pre-molded applications. It provides reliable and repeatable device attach, coupled with exceptional attachment speed and accuracy. ESEC 3088I P is equipped with a 30 by 40 cm stainless steel bonding table, capable of reliably mounting substrates up to 0.254mm thick. This table is driven by a pneumatic mechanism for precise placement of devices and can be used with both fixed and mobile fixtures. 3088 IP offers a wide range of process temperature control, with a range of 100-350 degrees Celsius, providing flexibility and stability for high-temperature bonding applications. 3088I P can be used with a variety of feeders and robotic arms, allowing for flexible automation. It is also equipped with a dual-camera system for alignments, providing enhanced precision during wire bonding processes. ESEC 3088 IP iscontrolled by a multi-function console, featuring a range of tools for advanced process management and monitoring. These include gauge sensing facilities, a height positioning system, and the ability to apply various flip chip bonding techniques. 3088iP features a host of safety features, including remote control shut-off in case of emergency, as well as automatic protection for mismatched feeder use. In addition, the bonder features a user-friendly graphical interface, which allows for clear operational status monitoring of all processes. Finally, the device is equipped with an integrated thermal transfer unit that enhances device attachment quality while reducing wire bond elongation. In summary, ESEC 3088iP is an effective and reliable bonder, offering a range of advanced features suitable for most semiconductor manufacturing applications. It is flexible, accurate, and provides a robust and repeatable wire and ribbon bonding process.
There are no reviews yet