Used ESEC 3088iP #9091748 for sale
URL successfully copied!
Tap to zoom
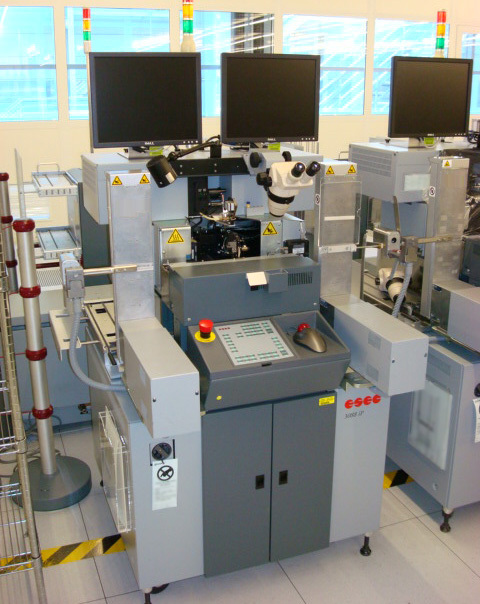

ID: 9091748
Vintage: 2002
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Maximum bonding area: 52 x 64 mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / Post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / Post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: Single / Multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ Finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Maximum wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227 mm / 8.93"
Width (adjustable): 120 mm / 4.72" to 260 mm / 10.23"
2002 vintage.
ESEC 3088iP is an fully-automatic, top-down bonder manufactured by ESEC. This versatile machine is ideal for applications that require high quality and efficient die and package bonding, such as ROM and PLD chips, QFPs, and Flip-Chip devices. ESEC 3088I P bonder is able to bond different types of devices simultaneously due to its high flexibility and configurability. 3088 IP features the latest technology available for top-down die attachment. Its advanced IR heating system allows the machine to bond packages up to 8x8mm in size. Also, the bonder is equipped with a high-frequency ultrasonic transducer that supports (capable of reaching up to 20 kHz). This ensures excellent adhesion and reliable bonds. The machine's XYZ stage is driven by a servo-motor to make precise and accurate movements in three directions, while a high-resolution camera allows for a full visual inspection of the die under bonding. 3088I P features an intuitive user interface that enables quick control and setup of all machine parameters. This feature makes the bonder an ideal solution for complex tasks. Additionally, the powerful AutoBond® software package allows for flexible programing and controlling of the bonder for automated production. The AutoBond package allows users to create, edit, and store bond programs, as well as provide detailed data for analysis and improvement of bond yields. The machine is also designed with safety in mind, and features ESEC patented Three-Point Force™ technique to ensure an accurate and safe bond. Overall, 3088iP is an advanced and reliable bonder that is suitable for die attachment applications in the electronics industry. With its high precision, high throughput, and flexible setup, this bonder is an excellent choice for a variety of demanding bonding applications.
There are no reviews yet