Used ESEC 3088iP #9091761 for sale
URL successfully copied!
Tap to zoom
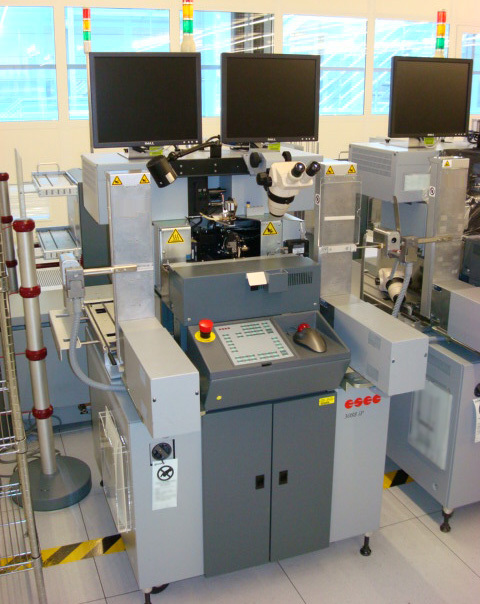

ID: 9091761
Vintage: 2003
Wire bonder
Flying bondhead:
Bond placement accuracy: ± 3.5 μm (3 Sigma)
Typical sprint UPH: (11) Wires / Second
Max. bonding area: 52 x 64mm / 2 x 2.5"
Indexer:
Process zone temperature: 50 to 300°C
Pre-bond / post-bond zone: 50 to 300°C
Process heater adapter blocks standard widths: 8/24/44 mm 0.31/0.95/1.73"
Pre / post-bond heater plates standard widths: 8/25/45/69 mm 0.31/0.98/1.77/2.72"
Wire:
Spool diameter: 50.8 mm / 2"
Spool width: 25.4 to 50.8 mm / 1 to 2"
Windings: single or multi layer
Gold wire diameter:
Standard: 17.5 to 50 μm / 0.7 to 2.0 mils
Capillary:
Length: 11.1 mm / 0.437"
Diameter 1.58 mm / 1/16"
PRS System:
Chip alignment:
Std. mode: 10 ms
Adv. mode: 30 ms
Leadframe alignment single mode: 10 ms
Finger alignment: ≤ 6 ms/ finger (304 ld)
Looping:
Flat loop: 125 to 250 μm < 8 μm, 5 to 10 mils < 0.3 mils
Standard loop: 125 to 200 μm < 8 μm, 5 to 8 mils < 0.3 mils
Typical data TSOP:
Wire length: 2 - 3 mm (140 μm 6 μm)
Typical data QFP:
Wire length: 3 - 4 mm (200 μm 8 μm)
Max. wire length: 7 mm / 280 mils
Wire straightness: < 1% of wire length
Magazine handling:
Magazine gripper with self-adjusting clamps
Buffer capacity magazine platform:
(4) Magazines for QFP 84 L/F
Loading / Unloading platform dimensions:
Depth: 227mm / 8.93"
Width (adjustable): 120mm / 4.72" to 260mm / 10.23"
2003 vintage.
ESEC 3088iP bonder is an innovative and versatile automated bonding solution that is designed to meet the demanding needs of today's semiconductor and electronics manufacturers. The equipment can be utilized in both production line environments and research and development (R&D) laboratories. It is powered by the latest in industry standard technology, providing high performance and precision results. The main frame of ESEC 3088I P is designed with rugged construction and solid-state components, making it strong and stable enough to withstand production line operation and reducing the cost of ownership over time. It has a large-screen LCD graphical user interface with an integrated touchscreen, making it easy to understand and operate. The LCD features various functions such as processing recipes, parameter changeover, and real-time status monitoring. In addition, the system includes a full range of inputs and outputs, allowing for network integration as well as data recording and traceability. 3088 IP is also equipped with a high-precision bonding head that provides accurate and repeatable results. It features an adjustable temperature range from 60 to 350°C, a pressure range from 0 to 100lbs, and adjustable thermal platen capabilities. The unit has multiple tooling adaptor choices, giving the flexibility to use any of the most popular bonder wires, capillaries, and tweezer tips available. The bonder is capable of carrying out high volume processes with speed, accuracy, and repeatability, making it suitable for a wide range of applications such as wirebonding, precision servo placement, and advanced optics assemblies. ESEC 3088 IP also includes an advanced vision machine that allows for motion control and defect detection. This makes it highly reliable and efficient and suitable for semiconductor fabrication and production as well as research and development (R&D). Overall, 3088I P is an advanced, versatile bonder that is designed to meet the specific needs of semiconductor and electronics manufacturers. It is powered by the latest in industry standard technology, providing high performance and precision through a range of bonding and positioning capabilities. The tool is rugged and reliable with a large-screen LCD graphical user interface and touchscreen, making it easy to use. 3088iP is an ideal choice for both production line and R&D laboratories.
There are no reviews yet