Used EATON NOVA / AXCELIS GSD 200E2 #9021872 for sale
It looks like this item has already been sold. Check similar products below or contact us and our experienced team will find it for you.
Tap to zoom
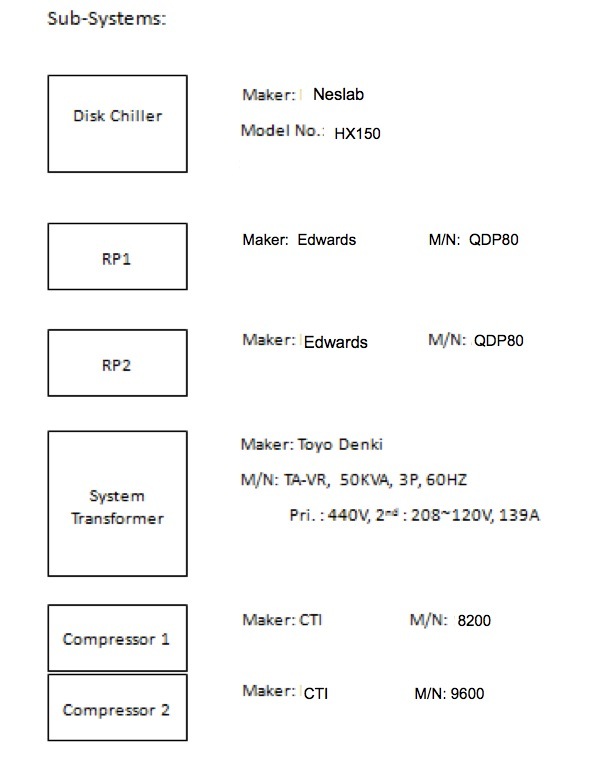

Sold
ID: 9021872
Wafer Size: 6"-8"
HC implanter, 6"-8"
180 KeV
Line power:
Input power: 208 V, 3 phase, 60 Hz, 92 A, 33 kVA, I/P breaker: 125 A
Output power: 180 KeV, 20 mA
Endstation module:
Mini-environment: Synetics
ATM robot: SEN
Notch / flat finder: flat
Dummy cassette: 2 in 1
Load buffer: 1
Vacuum cassette: domed pin
Cassette table: 4
Load port interface: manual
Beam profile oscilloscope: Tektronix TDS210
Cell controller / version: MVME 177-03
Load lock type: GSD 100/200, HE
Main SUN computer: Sparc Station 5
Second SUN computer: Spare 5
Second SUN monitor: Sun
Tape reader: n/a
Printer: HP
Process module:
Disk: none
Faraday flag: Y (no burn-through sensor)
Electron / plasma shower: secondary electron
Plasma shower PS: EMI EMS series
Bias aperture: Y
Shower gas panel: Y (Ar)
Ar / Xe bleed MFC: Unit 5 SCCM
In-vac arm: Y
Wafer holder: Y
Pedestal: Y
Gyro / angle: NF-GSD 100, Quad ± 11 deg
Linear drive: Y
Rotary drive: direct drive
HYT: no
Beamline module:
HV power supply: Advance HV
HV stack: OL8000/104/05, 100 kV
Prost accel. volt: OL800/104/05, 100 kV
Extraction suppression PS: Glassman, m/n: PS/NV-15NN33
AMU: BSL
AMU PS: EMI EMS 40-150
Hall probe: AMU
Max extraction voltage: 90 KeV, max acc. voltage: 90 KeV
Beam profiler hole: extended Y-scan
Decel. funcion: n/a
Beamline purge kit: Y
Beamline turbo: Y
Source module:
Source head: ELS without vaporizer
Filament PS: EMS 10-60
Arc PS: EMS 150-7
Cathode PS: Y
Vaporizer PS: present
Source magnet: std
Source magnet PS: EMS 25-25
Source bushing: std (orange)
Extraction assembly: LE-VAE, 33 type
Selectable resolving aperture: Y
Source ISO transformer: dry
Source injection kit: MKS 1150 vapor source MFC
Source housing exhaust valve: Y
Gas box module:
Gas box type: modular
Gas loop #1: Ar, HP (external supply)
Gas loop #2: BF3, SDS (fitting: 1/4" VCR)
Gas loop #3: AsH3, SDS (fitting: 1/2" VCR)
Gas loop #4: PH3, SDS (fitting: 1/2" VCR)
Loop #1 MFC: MKS, m/n 1179A-14493, 10 sccm, N2, gold finger conn.
Loop #2 MFC: MKS, m/n 1640A-011, 5 sccm, AsH3, D-15 conn.
Loop #3 MFC: MKS, m/n 1640A-011, 5 sccm, AsH3, D-15 conn.
Loop #4 MFC: MKS, m/n 1640A-011, 5 sccm, AsH3, D-15 conn.
Vacuum system:
P1 / source turbo: Seiko Seiki, STP-A2203C
P8 turbo: Leybold 1000C
P3 / V3 cryo pump: CTI-10
P9 / disk cryo pump: n/a (flange ready)
RP2: Ebara A70W, 200-220 V, 3 phase, 50/60 Hz, 29.5 A
IG1: glass, G-75
PIG1: n/a
IG2: glass, G-75
IG3: glass, G-75
IG4: n/a
IG controller: GP-307
Safety options:
VESDA: n/a
Smoke detector: Y
CES options: n/a
Others:
Enclosures: OK
Ground bars: 5
SECS / GEM function: GEM
SPC function: yes
Dose controller PComp. algorithm type: standard PComp.
Crated
1998 vintage.
EATON NOVA / AXCELIS GSD 200E2 is an ion implanter and monitor. It is designed to be used in semiconductor fabrication facilities for the process of ion implantation. This process is used to modify different materials with different ions to create different properties or features in the material, such as adding impurity dopant atoms to silicon material for specialized electronic properties. AXCELIS GSD 200E-2 utilizes proprietary components such as the OptiCap hybrid beam shaping technology and IonControl SmartScan ion beam delivery equipment to ensure the highest levels of precision and accuracy in the implanting process. This is essential in order to ensure that the resulting material has the desired properties and features. EATON NOVA GSD 200 E2 also uses a range of sensors to monitor particulate contaminants in the implantation chamber, as well as for tracking system performance and diagnostics. This is important in order to ensure the implanting process is optimized for the highest levels of quality in the resulting material. EATON NOVA GSD 200E2 unit is composed of several components, including an Ion Source, Implant Chamber, Vacuum Pumping Machine, RF Acceleration, High Voltage Tool, Ion Control Console, and a High Paramerter Control Asset. The Ion Source is responsible for generating the ions for the implantation process, while the Implant Chamber houses these ions and helps to accelerate them to the appropriate energy levels. The Vacuum Pumping Model is responsible for creating the appropriate vacuum environment for continued implantation. The RF Acceleration equipment boosts the ions to their required energy states for implantation. The High Voltage System supplies the electrical power necessary for these processes. The Ion Control Console is what allows operators to control the implantation process and the High Parameter Control Unit enables the monitoring of the implantation process and the additional sensors. In addition, EATON NOVA GSD 200E-2 features an integrated Passive Plasma Neutralization Chamber which eliminates the need for a separate device to neutralize the implantation chamber. This feature helps to ensure that higher levels of chamber stability are achieved and that there is less chance of contamination from the process. EATON NOVA / AXCELIS GSD 200E-2 is an advanced ion implanter and monitor, and it is essential in order to ensure that the highest levels of precision and accuracy are achieved in the implantation process, and that the resulting material has the desired properties. This is why it is used in many semiconductor fabrication facilities around the world.
There are no reviews yet