Used NOVELLUS CONCEPT 2 Dual Sequel #9092631 for sale
URL successfully copied!
Tap to zoom
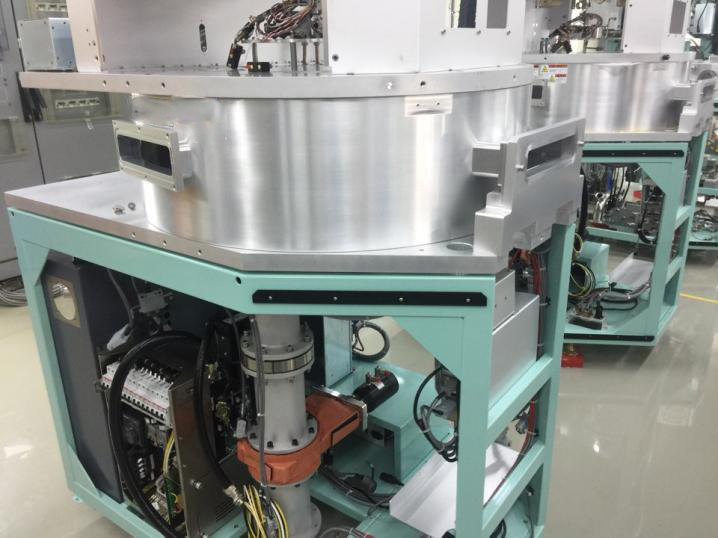







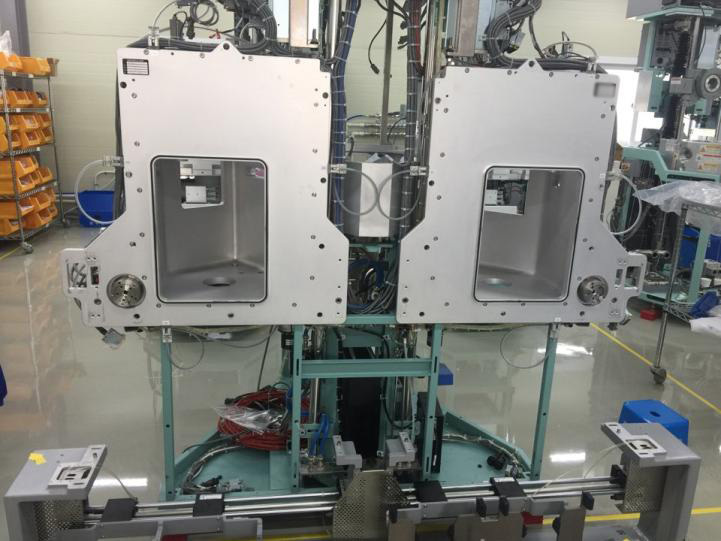

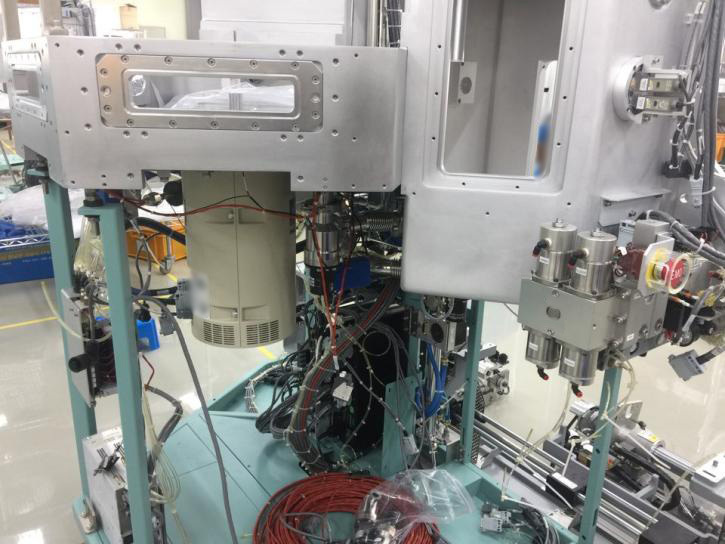







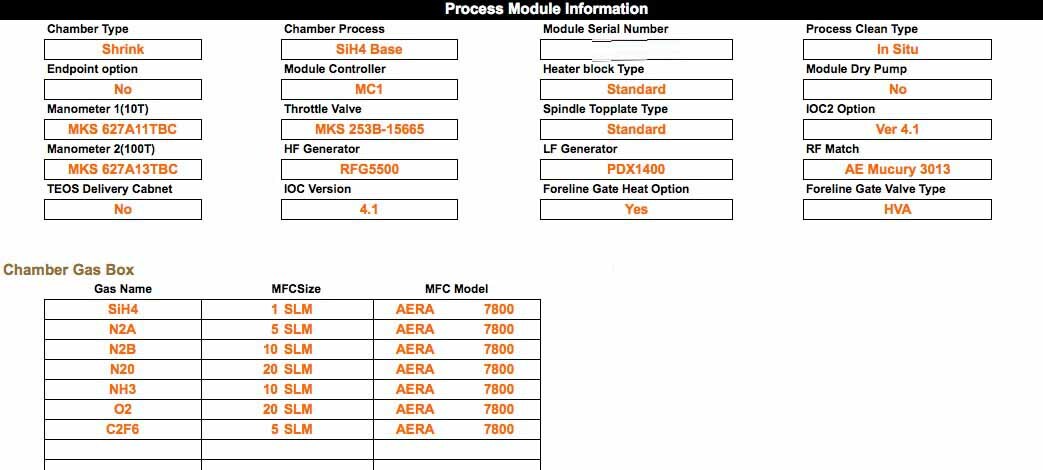

ID: 9092631
Wafer Size: 6"
CVD system, 6"
Software: C2.SEQ_4.92B15
Operating system: QNX4
SECS GEM: Yes
Free cable length: 75 Ft
RF Cable length: 84 Ft
Indexer firmware: 2.0_G
Transfer robot: Brooks Mag 7
Chamber location: Left
Chamber model: C2-CVDD-S SEQX
EPD: Verity dual wavelength
Shower head: Al 6061 8" 16-033931-00
Handling wafer size: 6"
Heater block: No slot Sequel STN 1 pin 19-00154-04
Spindle speed: Standard
Fork assembly: Ceramic anti-deflect
15-101482-00
15-101482-01
15-00700-00
Fork type: Min Contact
15-053394-02
Spindle feed through: Ferro fluidic
Primary process gauge: 10T
Gate & throttle valve: Heated / Internal
02-260348-00
16210-0403QS-002HJR
MFC Type: Brooks GF100
IOC Software version: 4.2
RF Switching option: Yes
RPC (Remote plasma clean): No
HF RF Generator: AE Apex 5513
LF RF Generator: AE PDX 1400
RF Match AE mercury: 3013
Foreline heated: No
2.0 MFC C Open
MFC B N2 (10000 sccm)
MFC A N2O (20000 sccm)
MFC 9 NF3 (5000 sccm)
MFC 8 O2 (20000 sccm)
MFC 7 Open
MFC 6 NH3 (10000 sccm)
MFC 5 Open
MFC 4 Open
MFC 3 Open
MFC 2 N2 (5000 sccm)
MFC 1 SiH4 (1000 sccm)
Chamber location: Rear
Chamber model: C2-CVDD-S SEQX
EPD: Verity dual wavelength
Shower head: Al 6061 8" 16-033931-00
Handling wafer size: 6"
Heater block: No slot Sequel STN 1 pin 19-00154-04
Spindle speed: Standard
Fork assembly: Ceramic anti-deflect
15-101482-00
15-101482-01
15-00700-00
Fork type: Min Contact
15-053394-02
Spindle feed through: Ferro fluidic
Primary process gauge: 10T
Gate & throttle valve: Heated / Internal
02-260348-00
16210-0403QS-002HJR
MFC Type: Brooks GF100
IOC Software version: 4.2
RF Switching option: Yes
RPC (Remote plasma clean): No
HF RF Generator: AE Apex 5513
LF RF Generator: AE PDX 1400
RF Match AE mercury: 3013
Foreline heated: No
2.0 MFC C Open
MFC B N2 (10000 sccm)
MFC A N2O (20000 sccm)
MFC 9 NF3 (5000 sccm)
MFC 8 O2 (20000 sccm)
MFC 7 Open
MFC 6 NH3 (10000 sccm)
MFC 5 Open
MFC 4 Open
MFC 3 Open
MFC 2 N2 (5000 sccm)
MFC 1 SiH4 (1000 sccm)
System main power: 3ϕ 5Wires 208V
System UPS power: 3ϕ 3Wires 120V
SMIF Interface: No
Aligner option: No
Loadlock dry pump model: No
Slit valve insert: No
Slit valve type: SMC L-Motion
TM Dry pump model: No
TM Throttle valve: MKS 253B
TM BARATRON model: MKS
Front monitor: 12" LCD
Chase monitor : LCD
Loadlock BARATRON model: No
Indexer robot type: Indexer II
IOC Version: 4.1
TM Robot type: Mag 7
TM Robot blade: Ceramic
Software revision: 4.80 B22
Signal tower: Yes
Module controller: MC1
Host interface: SECS
Module A: Express
Process A: SiH4 Base
Module B: Express
Process B: SiH4 Base
System and DLCM:
MC1 (P166 64M) System
DLCM Module controller
MSSD (2 Sequel configuration) power rack
Upgrade 4 cool station
SiH4 Base oxide process
Signal cables
RF Coaxial cables
MKS 253B throttle valve
651D Throttle valve controller
MAG 7 Transfer robot
Dual arm
Indexer robot
Animatics controller
Standard shuttle assy
Chase PC and table
Generator rack
Process module:
Chamber type: Shrink
Chamber process: SiH4 base
Process clean type: In Situ
Endpoint option: No
Module controller: MC1
Heater block type: Standard
Module dry pump: No
Manometer 1(10T): MKS 627A11TBC
Throttle valve: MKS 253B-15665
Spindle topplate type: Standard
IOC2 option: Ver 4.1
Manometer 2(100T): MKS 627A13TBC
HF Generator: RFG5500
LF Generator: PDX1400
RF Match: AE Mercury 3013
TEOS Delivery cabinet: No
IOC Version: 4.1
Foreline gate heat option: Yes
Foreline gate valve type: HVA
Chamber gas box:
Gas name MFC Size MFC Model
SiH4 1 SLM AERA 7800
N2A 5 SLM AERA 7800
N2B 10 SLM AERA 7800
N20 20 SLM AERA 7800
NH3 10 SLM AERA 7800
O2 20 SLM AERA 7800
C2F6 5 SLM AERA 7800
Module A :
Gas filters
Gas box
HF and LF RF Generators
RF Matching network
Lower spindle assy
Ferrofluidic spindle Assy
Bottom and top plates
10Torr and 1000Torr manometer
Heated type HVA gate and MKS throttle valves
Throttle valve controller
Upgrade MC1 (P166 64M) module controller
Ceramic type spindle fork assy
O-Rings
Metal parts in chamber
Watlow temp controller
Window shappire
Heater ISO box
TC gauge
MFC's
Heater block (OPM)
Shower head
RF and heater feedthru
2000-2001 vintage.
NOVELLUS CONCEPT 2 Dual Sequel is a reactor designed and manufactured by NOVELLUS Systems, Inc., a leading provider of plasma-based chemical vapor deposition (CVD) systems. The reactor is used in the fabrication of semiconductor devices in the sub- and ultra-micron sizes, and is well-suited for high-volume production of these components. This reactor includes a unique dual-chamber design that utilizes two separate chambers to deposit materials onto a substrate. The Dual Sequel reactor utilizes a chamber pressure of up to 10 Torr for deposition processes, ranging from very low to high film thicknesses. It also includes a detector unit for constant monitoring of the deposition process. For retaining thermal uniformity across the wafer, the reactor includes a wafer cooling feature designed to reduce detrimental effects from changes in wall temperature. Furthermore, this feature also helps to eliminate impurities from the process. The Dual Sequel reactor comes with a unique interlock equipment, which works by connecting the process chambers with one another via a shared vacuum line. This interlock ensures that both the chambers are working in tandem, thereby delivering reliable and consistent performance. The interlock also helps in regulating pressure throughout the system, allowing the chamber pressure to remain in the intended range. Other features include a highly-efficient gas delivery unit which helps in minimizing the use of process gases. The machine also operates in a special 'half-on' mode which can be used to speed up the process by performing a series of processes simultaneously. In addition, the Dual Sequel also provides a higher level of safety due to its advanced safety features like an emergency pump tool and a safety interlock. Overall, CONCEPT 2 Dual Sequel reactor is an advanced, high- throughput, and reliable CVD tool that is well-suited for high-volume production of small-sized semiconductor components. Its unique dual-chamber design offers greater levels of deposition and temperature control, while its interlock asset allows for a more unified and efficient process. It also boasts a range of features designed to enhance safety, minimize process gases, and boost throughput.
There are no reviews yet