Used WYKO / VEECO NT 3300 #9394877 for sale
URL successfully copied!
Tap to zoom








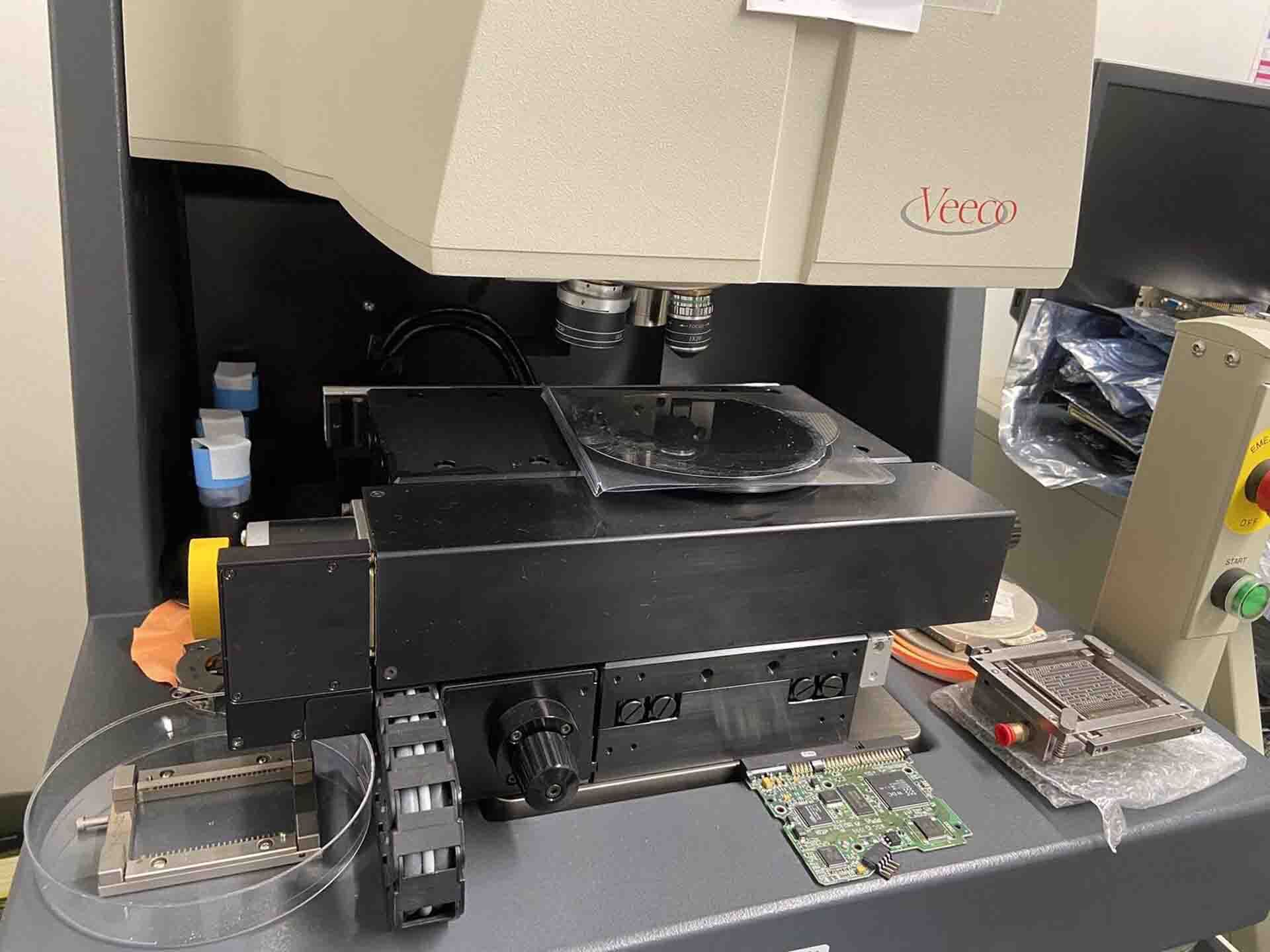





















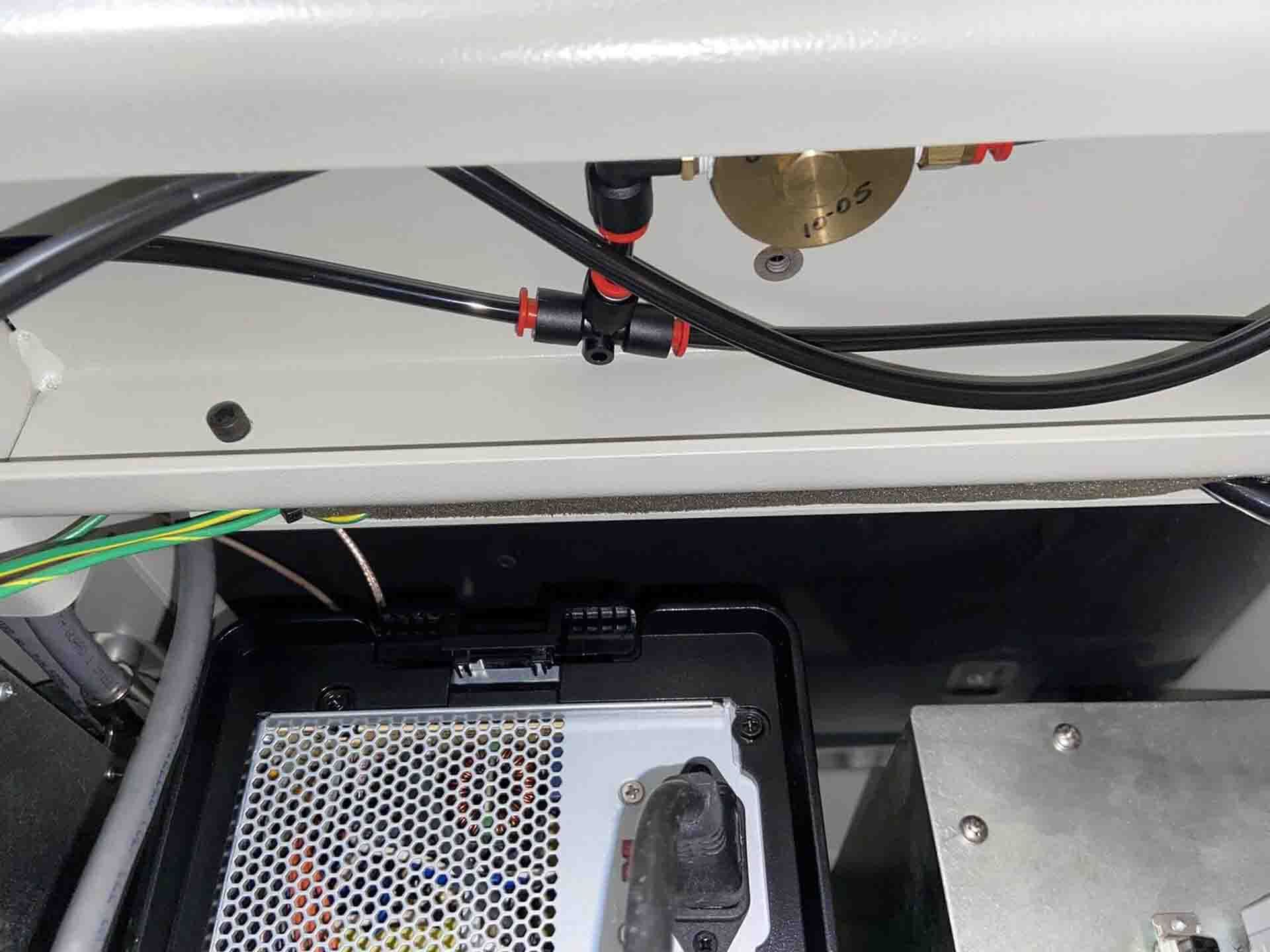











WYKO / VEECO NT 3300 is a wafer testing and metrology equipment designed for use in semiconductor manufacturing. It features an nanoscale resolution scanning microscope which is capable of capturing images with a resolution as low as 1 nanometer, allowing measurements to be made with a high degree of precision. The system also includes an automated multiple-angle surface profile measurement unit which enables the user to capture a 3-dimensional map of any given surface. In addition to its microscopy capabilities, WYKO NT 3300 also features a suite of automated wafer testing systems. This includes systems for critical dimension measurements, topology analysis, contamination detection, overlay measurement and tilt/rotation measurements. The automated wafer testing systems can measure multiple wafers at the same time, dramatically reducing the time required to complete process control measurements. VEECO NT 3300 also includes a tilt/rotation stage, which allows the user to rotate or tilt samples in order to get a better view of the surface. This feature is especially useful for making measurements on three dimensional samples such as MEMS or RF/microwave components. NT 3300 has an integrated image analysis software package, which automates the task of analyzing images captured by the machine's microscope. This image analysis software can be used to detect defects on the surface of wafers, allowing the user to quickly identify any problem areas. WYKO / VEECO NT 3300 is designed to be a powerful and efficient tool for process control measurement. Its nanoscale resolution microscope provides detailed images and measurements, while its suite of automated wafer testing systems allows multiple wafers to be tested in a single operation. The integrated image analysis software is also a useful tool for identifying defects on wafers. The tilt/rotation stage further enhances the tool's capabilities by allowing the user to get an improved view of complex samples.
There are no reviews yet




















