Used JEOL JEM 2010F #293585832 for sale
URL successfully copied!
Tap to zoom
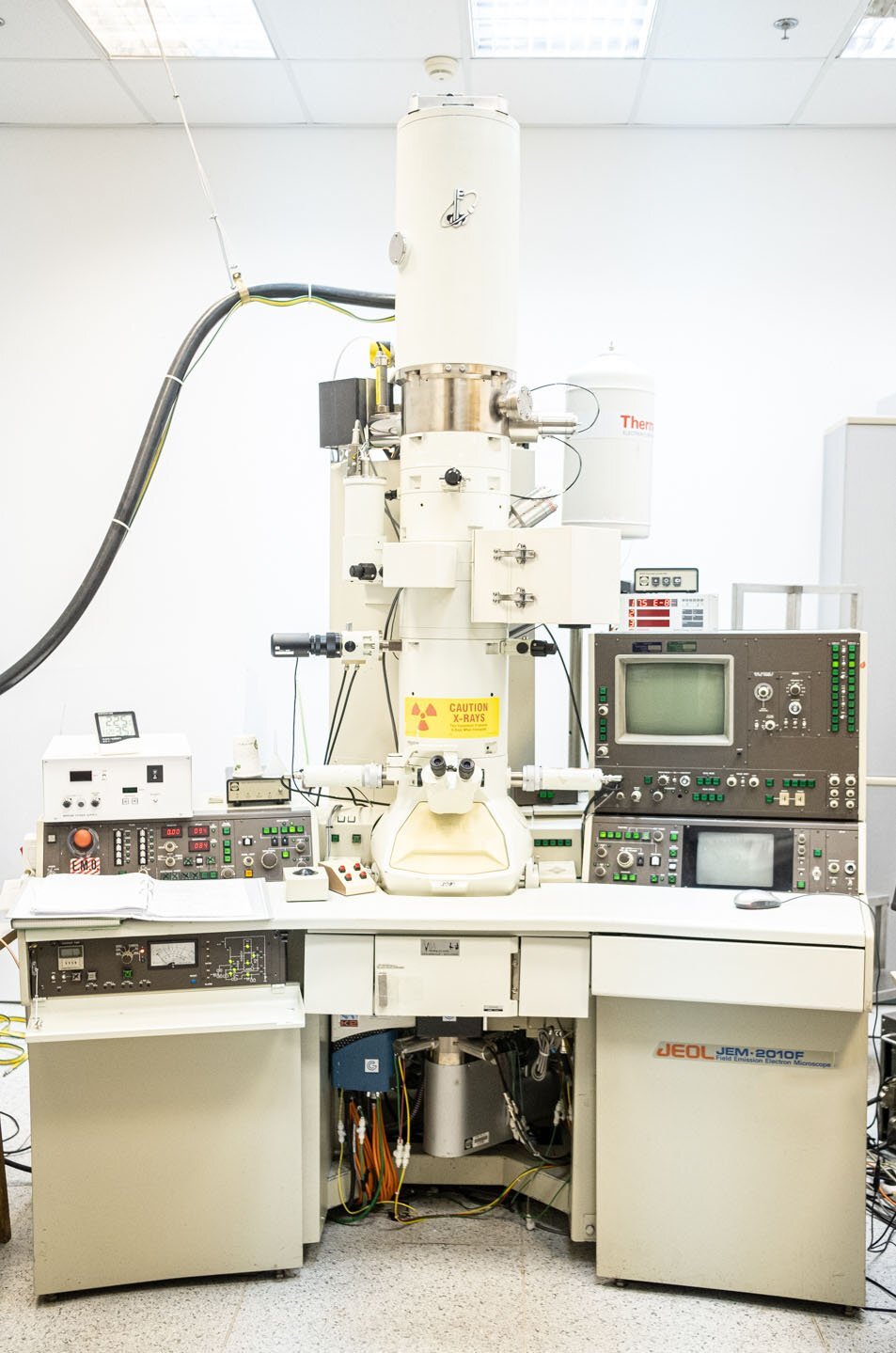





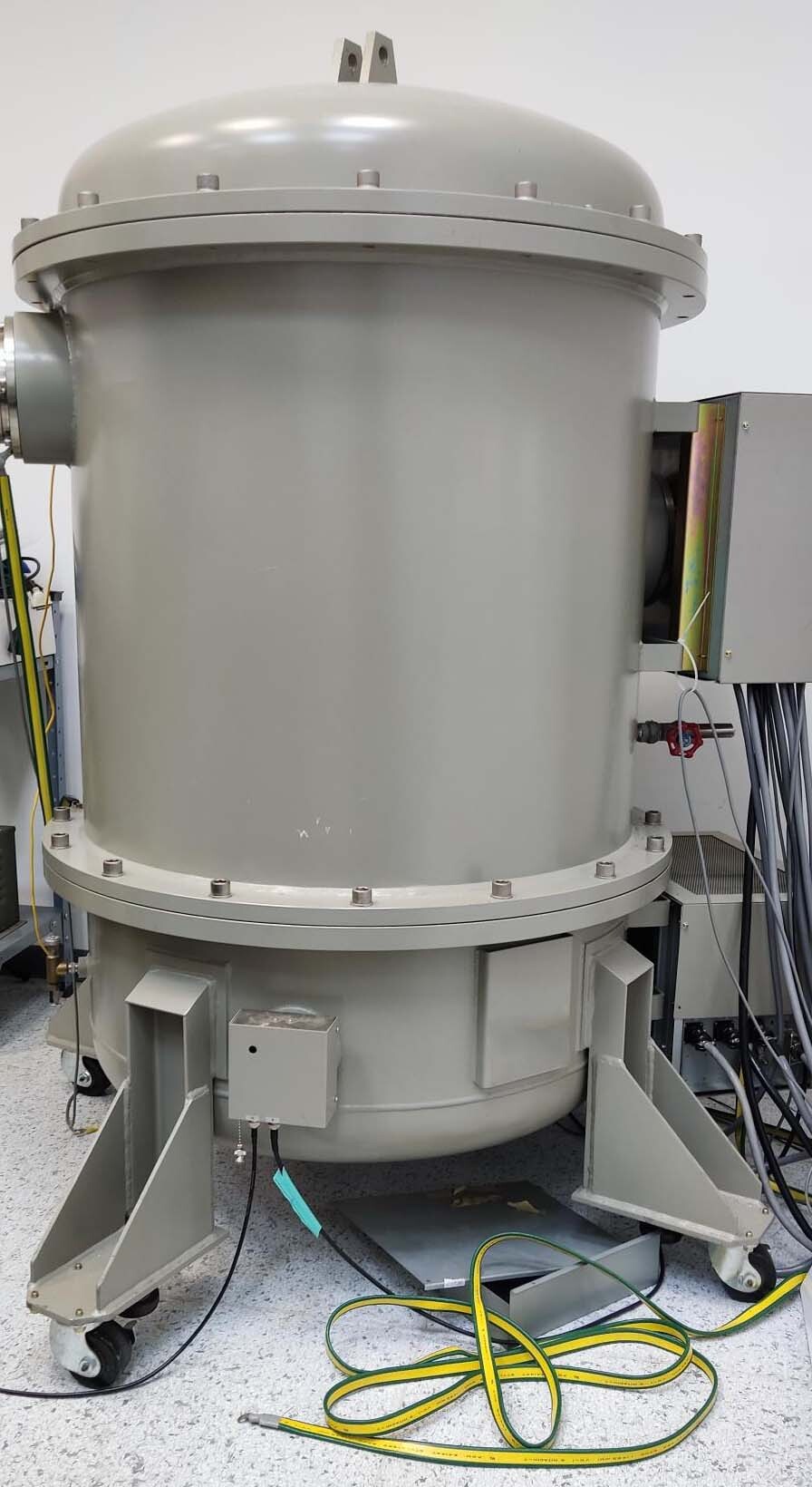









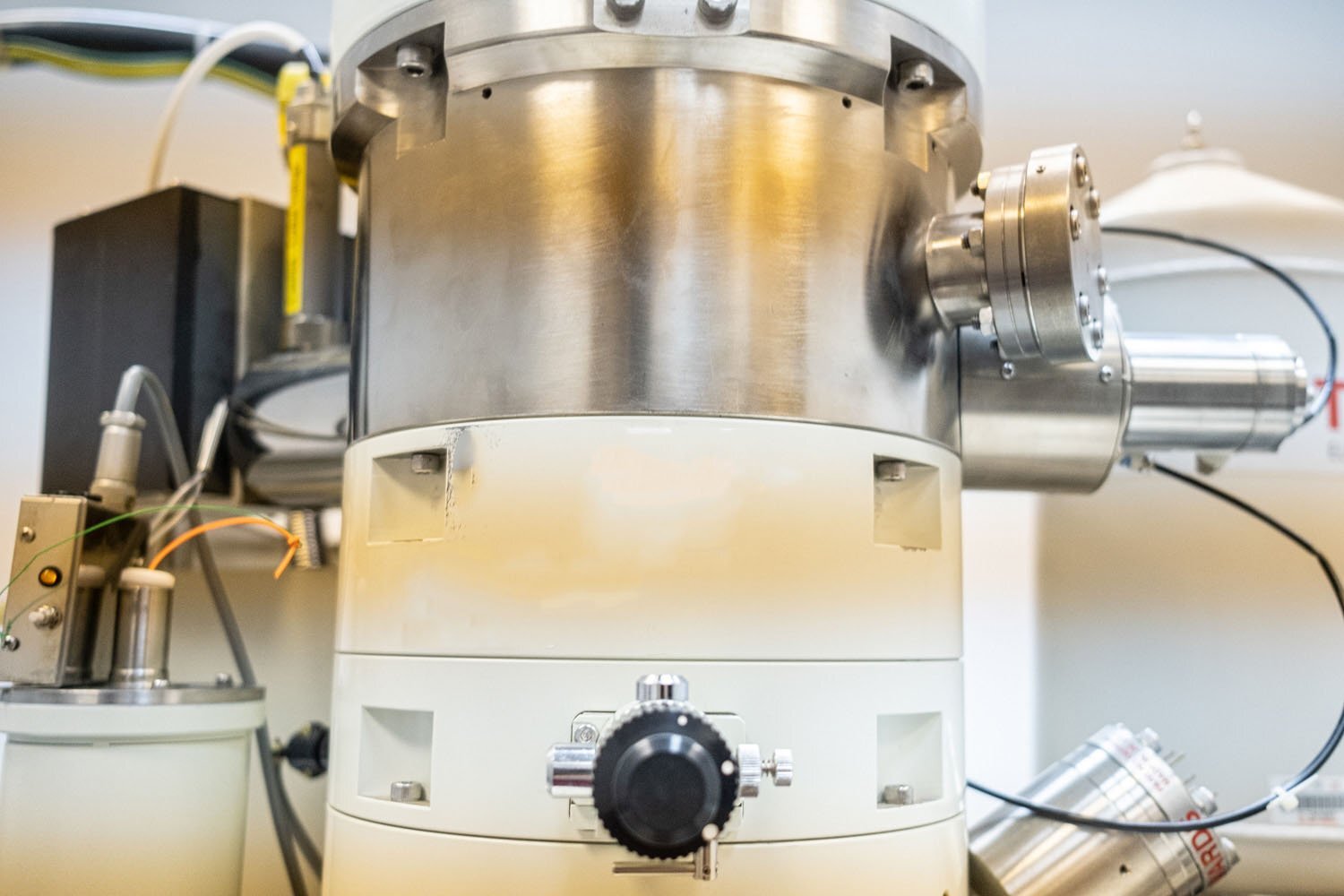































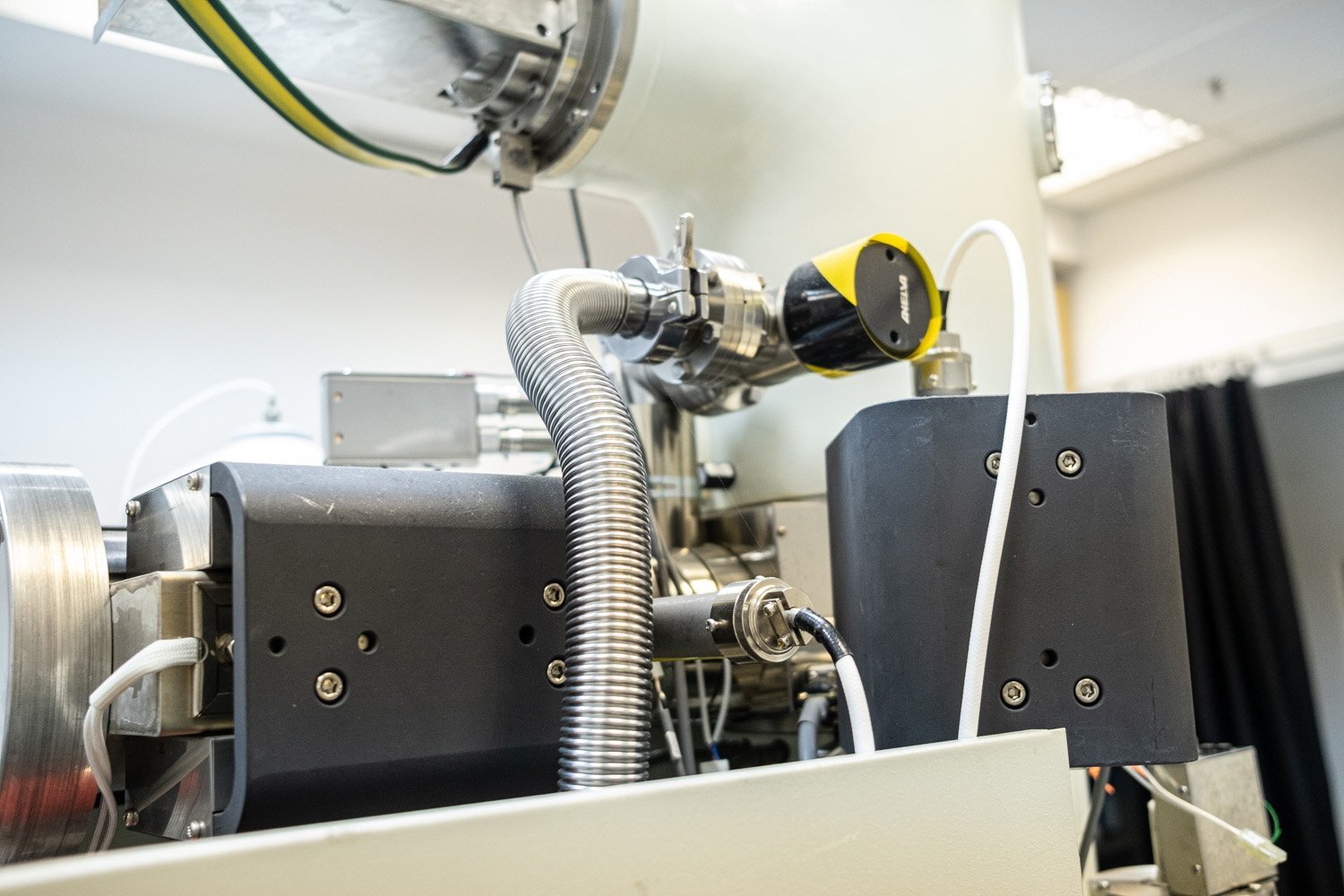





















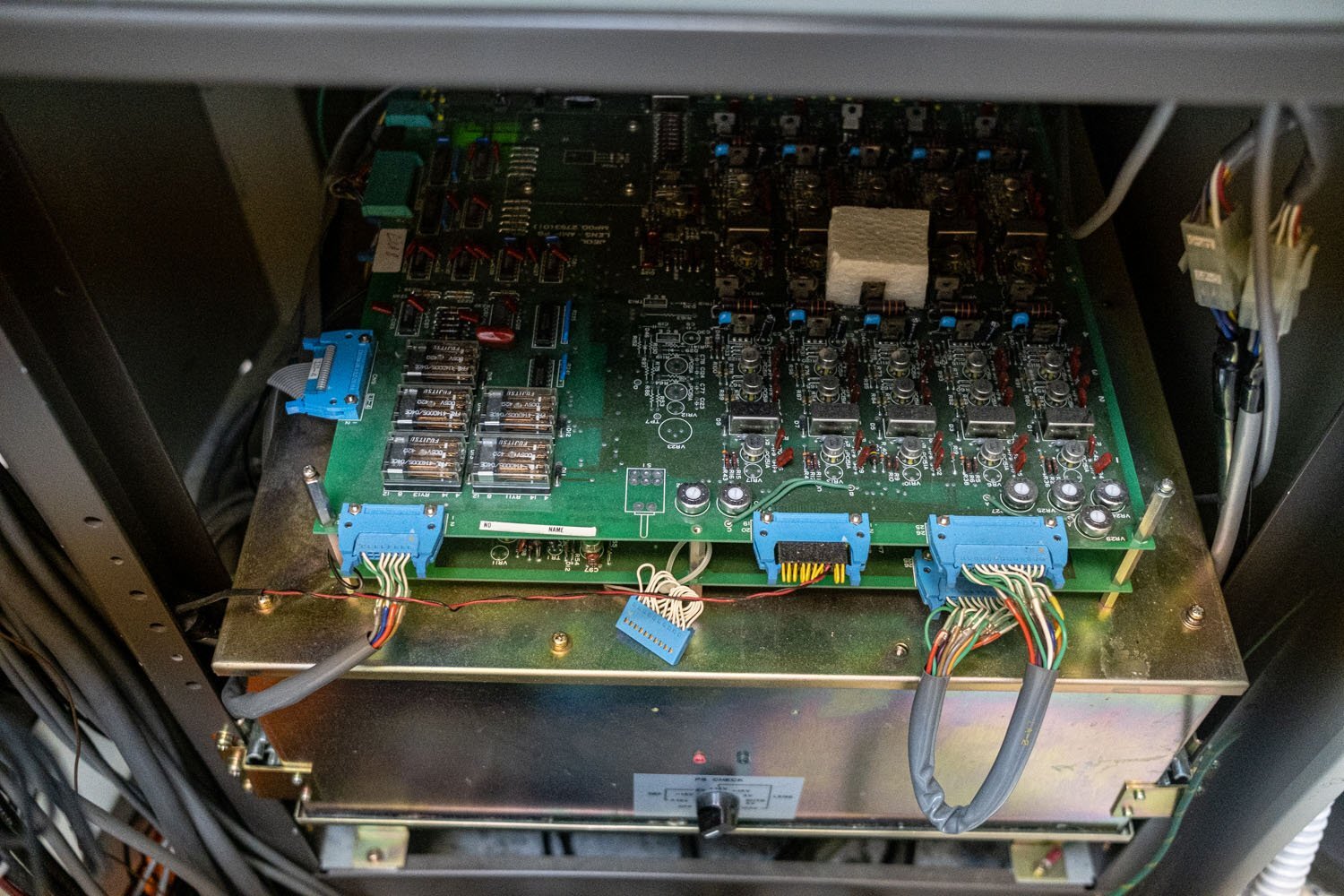

















































ID: 293585832
Scanning Transmission Electron Microscope (STEM)
UHR Objective pole
Spherical aberration coefficient: 0.5 mm
Point-point resolution: 0.19 nm
Information limit: 0.1 nm
Energy resolution: 133 eV
SiLi detector
Resolution imaging
Collection angle: 0.13 Sterad
Take off angle: 20°
Phase resolution: 100 rad
JEOL Bi-Prism electron holographic measurements
Medium and low magnifications
EDS
EELS
K2
Power supply: 80 kV-200 kV.
JEOL JEM 2010F is an advanced scanning electron microscope (SEM) that provides researchers, technicians, and industry experts with the tools necessary for sub-micron, feature level analysis. JEOL JEM-2010F is optimized for a variety of materials analysis, micron level observation, defect analysis and automated operation. JEM 2010F offers very high resolution imaging of small samples, including materials in both dry and liquid form. It is able to analyze a range of sample sizes, from that of the 1 micron apertures up to the 200 micron range. A large depth of field provided by JEM-2010F enables the capture of detailed images at high magnifications of up to 150,000X. The combination of high resolution and depth of field allows the detection of surface and subsurface high-contrast features such as inclusions, corrosion, grain boundaries and crystalline defects. JEOL JEM 2010F also provides a range of automated microscopy functions which are made possible by advanced software technology. The automated functions of JEOL JEM-2010F provide the user with many useful options, including combining image acquisitions from multiple stages of the analysis, working on multiple samples at the same time, and the use of various tools to control the scanning process. JEM 2010F also includes a number of advanced signal analysis options for a range of samples and analysis types. The signal analysis tools available in JEM-2010F can be used to analyze signal patterns, chromatic changes, and heat maps to detect changes in material microstructure at extremely small scales. The performance of JEOL JEM 2010F is further enhanced by its Intelligent Control Equipment (ICS). The ICS incorporates artificial intelligence to ensure the system works correctly each time it is operated and that imaging is optimized. The intelligent unit also allows fully automated measurement scenarios, providing the user with faster imaging, higher throughput and more consistent results. In conclusion, JEOL JEM-2010F is an advanced SEM with a range of features that allow real-time imaging with great levels of detail. The automated imaging and signal analysis functions provide a range of powerful tools to ensure high quality results while the Intelligent Control machine provides reliability and precision in every image.
There are no reviews yet